
Selon les informations publiées sur ce site Web le 22 août, Intel investit activement dans la recherche et le développement de processus avancés et renforce simultanément son activité d'emballage avancé. Il construit actuellement la dernière usine d'emballage à Penang, en Malaisie, et renforce son 2.5D. /Mise en page packaging 3D.
L'entreprise a annoncé son intention de quadrupler sa capacité de production d'emballages 3D Foveros d'ici 2025. Le vice-président d'Intel, Robin Martin, a révélé aujourd'hui dans une interview à Penang que la nouvelle usine de Penang deviendra à l'avenir la plus grande base d'emballage avancé 3D de l'entreprise.
En 2021, Intel a annoncé qu'il investirait 7,1 milliards de dollars américains (note sur ce site : actuellement environ 51,759 milliards de yuans) pour construire une nouvelle usine de conditionnement de semi-conducteurs de premier plan exploitée par Intel à Bayan Lepas, Penang.
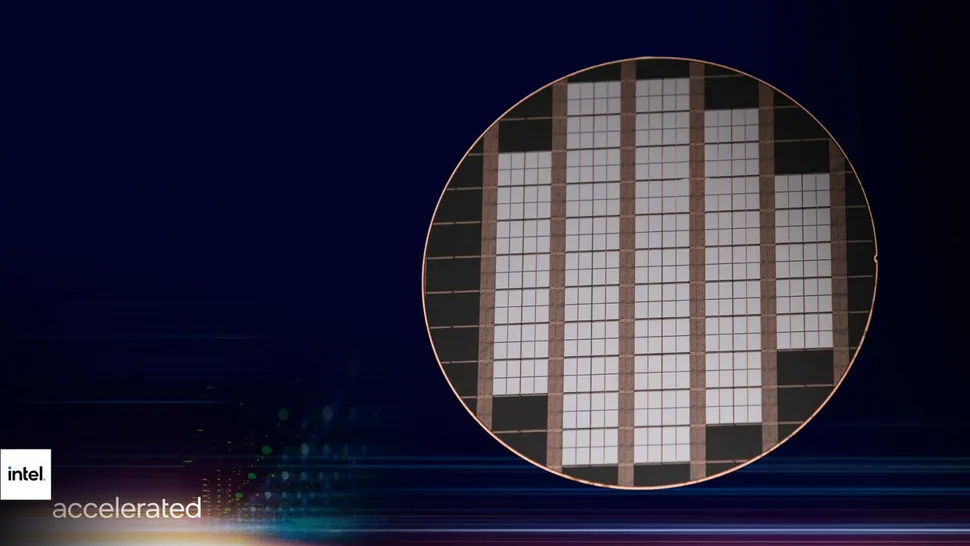
Selon Intel, l'emballage de la puce sert d'interface physique entre le processeur et la carte mère et joue un rôle essentiel dans les performances du produit. La technologie d'emballage avancée peut faciliter l'intégration de la technologie multi-processus par divers moteurs informatiques et aider à adopter de nouvelles méthodes dans l'architecture système.
Selon les rapports, la technologie d'emballage Foveros d'Intel utilise l'empilement 3D pour réaliser une intégration logique à logique. flexibilité pour mélanger et assortir des blocs IP technologiques avec divers éléments de mémoire et d'entrée/sortie dans de nouveaux facteurs de forme de périphérique. Les produits peuvent être divisés en chipsets ou tuiles plus petites, où les circuits d'E/S, de SRAM et d'alimentation électrique sont fabriqués dans la puce de base, et les chipsets ou tuiles logiques hautes performances sont empilés sur le dessus.
De plus, les nouvelles capacités d'emballage d'Intel se débloquent. de nouvelles conceptions en combinant les technologies EMIB et Foveros, permettant d'interconnecter différents chipsets et blocs avec des performances essentiellement équivalentes à une seule puce. Avec Foveros Omni, Intel affirme que les concepteurs peuvent bénéficier d'une plus grande flexibilité de communication en exploitant de petites puces ou blocs au sein d'un package.
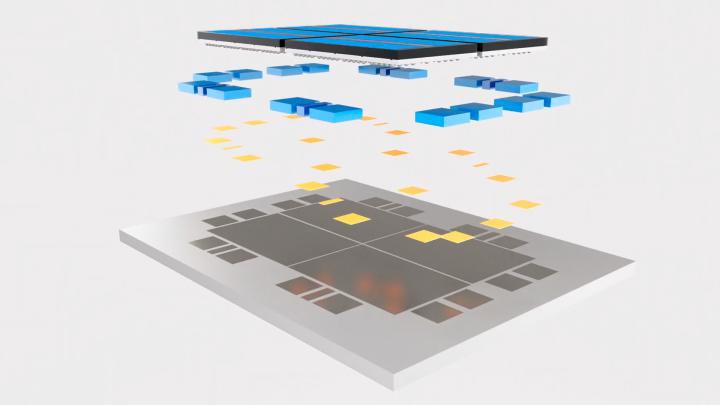
Déclaration publicitaire : cet article contient des liens de renvoi externes (y compris, mais sans s'y limiter, des hyperliens, des codes QR, des mots de passe, etc.), qui sont destinés à fournir plus d'informations et à gagner du temps de contrôle, et sont à titre de référence uniquement. . Veuillez noter que tous les articles de ce site contiennent cette déclaration
Ce qui précède est le contenu détaillé de. pour plus d'informations, suivez d'autres articles connexes sur le site Web de PHP en chinois!
 Logiciel antivirus
Logiciel antivirus
 collection de codes d'arrière-plan CSS
collection de codes d'arrière-plan CSS
 Ordre d'apprentissage recommandé pour C++ et Python
Ordre d'apprentissage recommandé pour C++ et Python
 Quels sont les outils de vérification de code statique ?
Quels sont les outils de vérification de code statique ?
 Introduction à toutes les utilisations de python
Introduction à toutes les utilisations de python
 VPN
VPN
 Le bloc-notes est le meilleur
Le bloc-notes est le meilleur
 L'installation de l'imprimante a échoué
L'installation de l'imprimante a échoué
 Collection complète de balises HTML
Collection complète de balises HTML