8월 22일 본 홈페이지의 소식에 따르면, 인텔은 첨단 공정 연구개발에 적극적으로 투자하는 동시에 첨단 패키징 사업도 강화하고 있으며, 현재 말레이시아 페낭에 최신 패키징 공장을 짓고 2.5D 사업도 강화하고 있다. /3D 패키징 레이아웃.
회사는 2025년까지 3D Foveros 패키징 생산 능력을 4배로 늘릴 계획이라고 밝혔습니다. Intel 부사장 Robin Martin은 오늘 페낭에서 열린 인터뷰에서 새로운 페낭 공장이 향후 회사 최대 규모의 3D 고급 패키징 기지가 될 것이라고 밝혔습니다.
2021년 인텔은 페낭 바얀 레파스에 인텔이 운영하는 새로운 선도적인 반도체 패키징 공장을 건설하기 위해 71억 달러(이 사이트 참고: 현재 약 517억 5900만 위안)를 투자할 것이라고 발표했습니다.
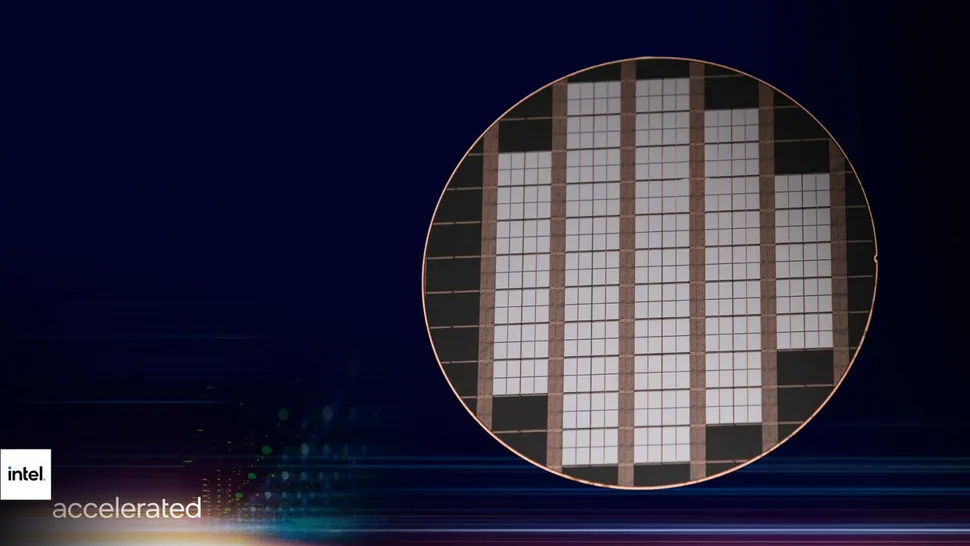
Intel에 따르면 칩의 패키징은 프로세서와 마더보드 사이의 물리적 인터페이스 역할을 하며 제품 수준 성능에서 중요한 역할을 합니다. 고급 패키징 기술은 다양한 컴퓨팅 엔진을 통해 다중 프로세스 기술의 통합을 촉진하고 시스템 아키텍처에서 새로운 방법을 채택하는 데 도움을 줄 수 있습니다.
보고에 따르면 인텔의 Foveros 패키징 기술은 3D 스태킹을 사용하여 로직 간 통합을 달성합니다. 기술 IP 블록을 새로운 장치 폼 팩터의 다양한 메모리 및 입력/출력 요소와 혼합하고 일치시킬 수 있는 유연성. 제품은 더 작은 칩렛 또는 타일로 나눌 수 있으며, I/O, SRAM 및 전원 공급 회로는 기본 칩에 제작되고 고성능 로직 칩렛 또는 타일은 그 위에 적층됩니다
또한 Intel의 새로운 패키징 기능이 잠금 해제됩니다. EMIB와 Foveros 기술을 결합하여 새로운 설계를 통해 다양한 칩렛과 블록을 본질적으로 단일 칩과 동일한 성능으로 상호 연결할 수 있습니다. Intel은 Foveros Omni를 통해 설계자가 패키지 내의 작은 칩이나 블록을 활용하여 더 큰 통신 유연성을 얻을 수 있다고 말합니다.
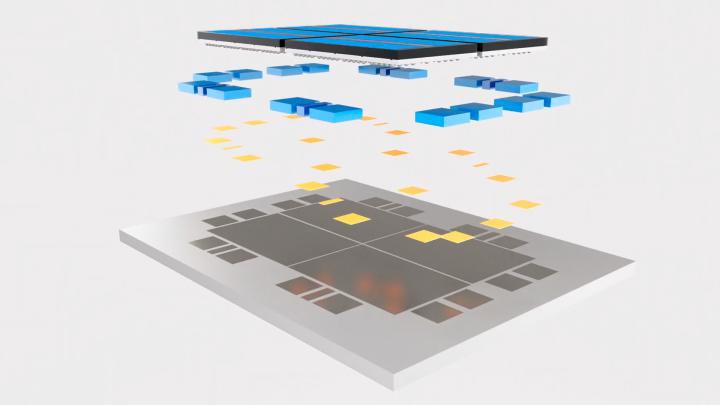
광고문: 이 글에는 더 많은 정보를 제공하고 상영 시간을 절약하기 위한 외부 점프 링크(하이퍼링크, QR 코드, 비밀번호 등을 포함하되 이에 국한되지 않음)가 포함되어 있으며 참고용입니다. . 이 사이트의 모든 기사에는 다음 내용이 포함되어 있습니다.
위 내용은 인텔은 2025년까지 3D Foveros 패키징 용량을 4배로 늘릴 계획입니다.의 상세 내용입니다. 자세한 내용은 PHP 중국어 웹사이트의 기타 관련 기사를 참조하세요!