
Menurut berita dari laman web ini pada 22 Ogos, Intel sedang melabur secara aktif dalam penyelidikan dan pembangunan proses lanjutan, dan pada masa yang sama mengukuhkan perniagaan pembungkusan termajunya Ia kini sedang membina kilang pembungkusan terbaharu di Pulau Pinang, Malaysia, dan mengukuhkan 2.5Dnya / Susun atur pembungkusan 3D.
Syarikat itu berkata ia merancang untuk meningkatkan kapasiti pengeluaran pembungkusan 3D Foveros sebanyak empat kali ganda menjelang 2025. Naib Presiden Intel Robin Martin mendedahkan dalam temu bual di Pulau Pinang hari ini bahawa kilang baharu Pulau Pinang itu akan menjadi pangkalan pembungkusan termaju 3D terbesar syarikat itu pada masa hadapan.
Pada 2021, Intel mengumumkan bahawa ia akan melabur AS$7.1 bilion (nota di laman web ini: pada masa ini kira-kira 51.759 bilion yuan) untuk membina kilang pembungkusan semikonduktor terkemuka baharu yang dikendalikan oleh Intel di Bayan Lepas, Pulau Pinang.
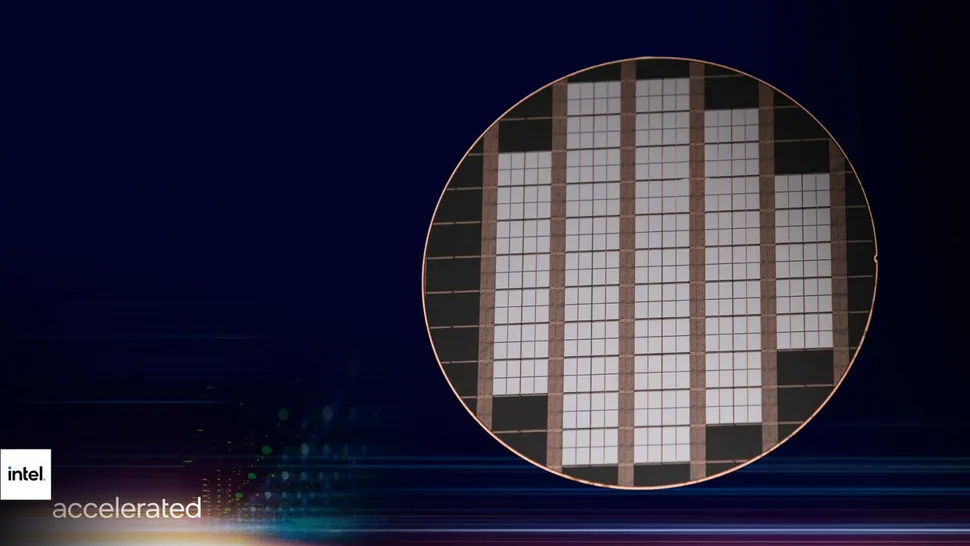
Menurut Intel, pembungkusan cip berfungsi sebagai antara muka fizikal antara pemproses dan papan induk dan memainkan peranan penting dalam prestasi peringkat produk. Teknologi pembungkusan lanjutan boleh memudahkan penyepaduan teknologi berbilang proses oleh pelbagai enjin pengkomputeran dan membantu menggunakan kaedah baharu dalam seni bina sistem
Menurut laporan, teknologi pembungkusan Foveros Intel menggunakan tindanan 3D untuk mencapai penyepaduan logik ke logik fleksibiliti untuk mencampur dan memadankan blok IP teknologi dengan pelbagai elemen memori dan input/output dalam faktor bentuk peranti baharu. Produk boleh dibahagikan kepada ciplet atau jubin yang lebih kecil, di mana I/O, SRAM dan litar penghantaran kuasa dibuat dalam cip asas, dan ciplet atau jubin logik berprestasi tinggi disusun di atas
Selain itu, keupayaan pembungkusan baharu Intel membuka kunci reka bentuk baharu dengan menggabungkan teknologi EMIB dan Foveros, membolehkan ciplet dan blok yang berbeza disambungkan dengan prestasi yang pada asasnya setara dengan satu cip. Dengan Foveros Omni, Intel berkata pereka boleh memperoleh fleksibiliti komunikasi yang lebih besar dengan memanfaatkan cip atau blok kecil dalam pakej.
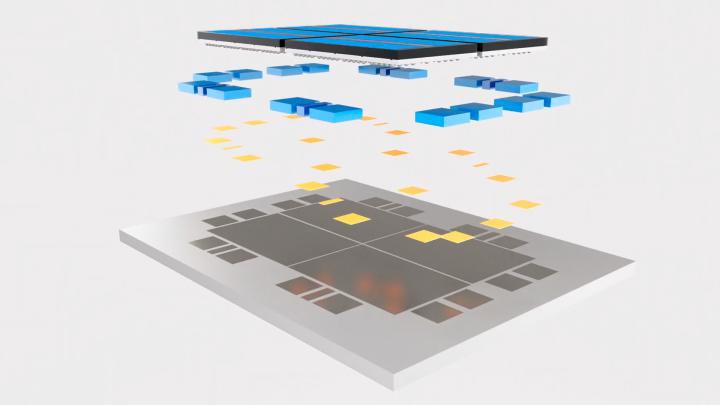
Pernyataan pengiklanan: Artikel ini mengandungi pautan lompat luaran (termasuk tetapi tidak terhad kepada hiperpautan, kod QR, kata laluan, dll.), yang bertujuan untuk memberikan lebih banyak maklumat dan menjimatkan masa pemeriksaan, dan hanya untuk rujukan . Sila ambil perhatian bahawa semua artikel di laman web ini mengandungi pernyataan ini
Atas ialah kandungan terperinci Intel merancang untuk meningkatkan kapasiti pembungkusan 3D Foveros sebanyak empat kali ganda menjelang 2025. Untuk maklumat lanjut, sila ikut artikel berkaitan lain di laman web China PHP!
 Apakah sistem pengurusan biasa?
Apakah sistem pengurusan biasa?
 mintui
mintui
 Versi sistem linux yang manakah mudah digunakan?
Versi sistem linux yang manakah mudah digunakan?
 Perkara yang perlu dilakukan jika ralat berlaku dalam skrip halaman semasa
Perkara yang perlu dilakukan jika ralat berlaku dalam skrip halaman semasa
 Apakah keperluan untuk siaran langsung Douyin?
Apakah keperluan untuk siaran langsung Douyin?
 Mengapa saya tidak boleh membuka pinterest?
Mengapa saya tidak boleh membuka pinterest?
 Pengenalan kepada Dokumen dalam JS
Pengenalan kepada Dokumen dalam JS
 Apakah format nama akaun stim
Apakah format nama akaun stim
 Apakah sistem erp perusahaan?
Apakah sistem erp perusahaan?




